Resist des Monats
Juli 2015: Prozessangepasster Zweilagenresist AR-BR 5460
Der Bottom Resist AR-BR 5460 wird in Kombination mit Positiv- (z.B. AR-P 3510) oder Negativresists (z.B. AR-N 4340) seit einem Jahrzehnt bei vielen Lift-off-Applikationen eingesetzt. Prozess: Zuerst wird der nicht lichtempfindliche Unterlack AR-BR 5460 beschichtet und bei 150 °C getempert. Dann wird der jeweilige Photoresist auf den Unterlack aufgeschleudert und normal bei 95 °C getrocknet. Nach der UV-Belichtung und Entwickeln stellt sich der gewünschte Unterschnitt durch die eingestellte Entwicklungsrate des Bottom Resists ein. Mit diesen Strukturen kann sehr leicht ein Lift-off-Prozess realisiert werden.
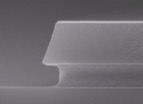
Unterschnitt mit Negativresist
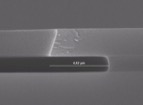
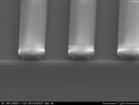
Unterschnitt mit dem Standardsystem AR-BR 5460/AR-P 3510 (unterschiedliche Entwicklungszeiten)
Die Prozesse bei den Anwendern unterscheiden sich jedoch oft. Die Einflüsse von Substrat, Resist, Entwickler, Temperregime, Strukturgröße und Schichtdicke machen eine Prozessoptimierung notwendig. Um unsere Kunden dabei zu unterstützen, haben wir Untersuchungen mit Modifikationen des Bottom Resists durchgeführt. Der wichtigste Parameter ist in diesem Zusammenhang die Entwicklungsrate, da sie den erreichbaren Unterschnitt bestimmt.
In Diagramm sind unterschiedlichen Entwicklungsraten von vier Mustern des AR-BR 5460 in Abhängigkeit vom Novolakanteil bei unterschiedlichen Softbake-Temperaturen zu sehen:

Diagramm Verlauf der Entwicklungsraten
So variiert z.B. die Löserate bei dem Muster mit 15 % Novolak von 155 nm/s bei 150 °C bis 40 nm/s bei 170 °C. Mit einer solchen Auswahl-Möglichkeit lassen sich für jede Technologie die optimalen Parameter finden.
Diese hohe Flexibilität war uns Anlass, die Modifikationen des AR-BR 5460 zum Resist des Monats Juli zu küren.
