PMMA-Resists werden überwiegend für Elektronenstrahlanwendungen oder als Schutzlacke bei aggressiven nasschemischen Ätzverfahren eingesetzt. Prinzipiell ist die Strukturierung einer PMMA-Schicht auch mittels Tief-UV-Belichtung (220 – 266 nm) möglich. Jedoch ist dort die Empfindlichkeit gering und es resultieren lange Belichtungszeiten.
Dies war der Anlass, nach einer empfindlicheren PMMA-Variante zu suchen. Es gelang das Prinzip der chemischen Verstärkung auf PMMA-Polymere zu übertragen. Der neue Speziallack SX AR-N 4810/1 ist ein chemisch verstärkter Photoresist, der auf PMMA basiert und wasserfrei – entscheidend im Fall feuchtigkeitsempfindlicher Substrate – mit organischen Lösungsmitteln entwickelt werden kann. SX AR-N 4810/1 wird als Lösung in Anisol angeboten.
Mit dem Lacksystem können (auf Nachfrage hin) auch dickere Schichten bis zu etwa 5 µm realisiert werden. Für die maximalen Schichtdicken eignet sich unser Entwickler X AR 300-74/3 besonders gut, die Empfindlichkeit liegt im Bereich von etwa 600 – 650 mJ/cm2 (Breitband UV).
Die neue chemisch verstärkte Rezeptur zeichnet sich durch eine sehr gute Empfindlichkeit in dem Wellenlängenbereich von 300 – 410 nm aus. Belichtungen sind jedoch auch bei g-line (436 nm), wenn auch mit deutlich geringerer Empfindlichkeit, noch möglich.
Abb. 1: Transmissionsspektrum, Einfluss zunehmender Belichtungsdauer auf die Transmission (Hg-Lampe)
Mit dem neuen Experimentalmuster SX AR-N 4810/1 sind Lackdicken bis zu etwa einem Mikrometer möglich: ~650nm (1000rpm), ~480nm (2000 rpm) und ~320nm (4000rpm). Der Entwickler besteht aus einem Ethylbenzol-Lösemittelgemisch: X AR 300-74/1.

Abb. 2: Mit dem neuen Experimentalmuster SX AR-N 4810/1 erhaltene Balkenstruktur
Die resultierenden Strukturen sind bis etwa 230 °C stabil und im optischen Wellenlängenbereich >300 nm transparent.
An der MLU Halle wurde SX AR-N 4810/1 auch hinsichtlich seiner Eignung als Resist für Interferenzlithographie untersucht. Da die die LIL-Belichtung nur mit sehr geringer Leistung erfolgte (bei 266nm mit ~0,3 mW/cm2) sind vergleichsweise lange Belichtungszeiten erforderlich:
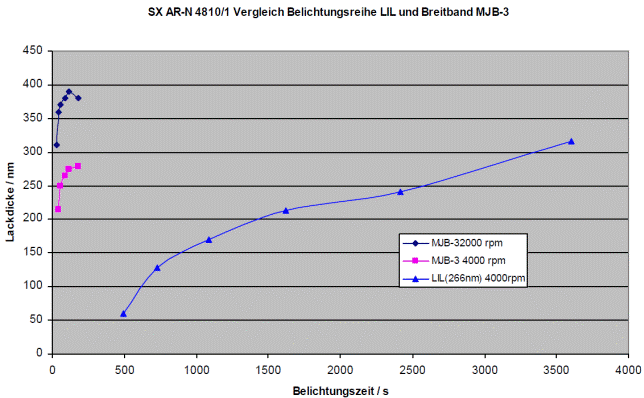
Abb. 3: Belichtungsreihe LIL und Breitband MJB-3 mit SX AR-N 4810/1
Während durch eine Belichtung mi der Hg-Lampe (Breitband UV, ~10 mW/cm2) die maximalen Schichtdicken bereit nach etwa 2 Minuten erhalten werden sind bei der Interferenzlithographie dafür etwa 60 Minuten erforderlich.
Der Standardprozess erlaubt die Herstellung gut definierte Resistarchitekturen:
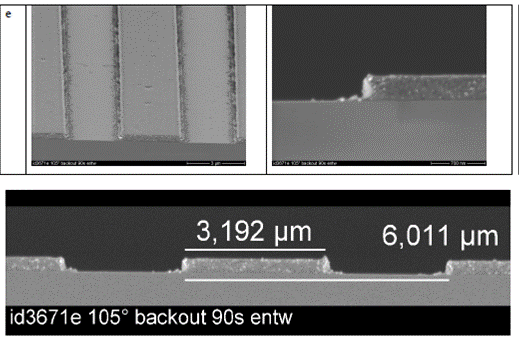
Abb. 4: Resistarchitekturen mit SX AR-N 4810/1
Optimale Prozessparameter:
- 3 Minuten Belichtung (Breitband UV)
- 5 Minuten PEB bei 105°C
- Entwicklungsdauer: 135s mit X AR 300-74/1
Photoresist Andere Resists