Neue, wässrig-alkalische lösliche Polymere können die Novolake in einigen Eigenschaften übertreffen. Die Standard-Novolake schmelzen in der Regel in dem Bereich von 120 – 140 °C. Je dicker die Schichten werden, desto größere Auswirkung hat dieses Verhalten auf die Resiststrukturen. 10 µm hohe Stege können bei 130 °C einfach wegfließen. Eine hohe thermische Stabilität würde diesen Effekt vermeiden, besonders bei Ionen- oder Plasmaätzschritten.
Versuche mit einem wässrig-alkalisch entwickelbaren Copolymer aus PMMA und Polyhydroxystyren zeigten eine hohe thermische Resistenz der Schichten. Dieses Polymer ergab durch die Zugabe von Säuregeneratoren und aminischen Vernetzern die chemisch verstärkten Negativresists SX AR-N 4340/7. Ausgehend von Polymer Polyhydroxystyren konnte auch der ebenfalls sehr empfindliche und äußerst thermostabile Resist SX AR-N 4340/6 entwickelt werden. Wie für chemisch verstärkte Resists zu erwarten, sind diese negativen Lacke sehr empfindlich. Neben dem Einsatz als Einlagenresist ist auch eine Applikation für ein Zweilagensystem mit Bottomresist AR-BR 5480 möglich, wobei definierte unterschnittene Strukturen erzeugt werden können.
Die Versuche zur Bestimmung der thermischen Stabilität zeigten bei einer Schichtdicke von 5,5 µm bis über 300 °C keine Verrundung der Kanten.
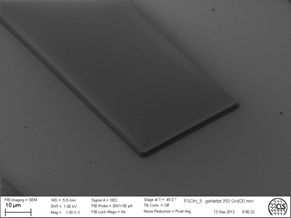
REM-Aufnahme einer bei 350 °C getemperten Struktur des SX AR-N 4340/6 mit glatter Oberfläche u. scharfen Kanten

Schrumpfung in Abhängigkeit von der Temperatur, Messung am Dektak 150
Die Strukturen der Lacke halten Temperaturen bis zu 350 °C formtreu aus. Es tritt lediglich eine Schrumpfung bis zu etwa 20 % durch Sinterprozesse auf.
Das Copolymer wird auch erfolgreich für eine positive Lackvariante eingesetzt, die speziell für Hochtemperaturanwendungen und Ionenimplantationsprozesse gut geeignet ist (vgl. SX AR-P 3500/8).
Photoresist Negativ
