Prozessstabile Negativ-Lacksysteme, die bei einer ausreichenden Empfindlichkeit Auflösungen < 30 nm ermöglichen, sind von zunehmenden Interesse für Anwendungen der Elektronenstrahllithographie. Viele chemisch verstärkten E-Beamresists verfügen zwar über eine sehr hohe Empfindlichkeit, eignen sich aber bisher nur für die Herstellung von Strukturen bis zu einer Auflösung von etwa 100 nm. Nicht chemisch verstärkte E-Beamresist (z.B. AR-N 7500) besitzen zwar das Potential für Auflösungen < 30 nm, sind dafür aber weniger empfindlich und erfordern daher unökonomisch lange Schreibzeiten.
Seit Mitte 2012 ist unser hochempfindlicher, negativer E-Beamresist AR-N 7520 neu auf dem Markt, der Strukturauflösungen von etwa 30 nm bei einer hohen Empfindlichkeit ermöglicht und außerdem eine sehr gute Langzeitstabilität aufweist. AR-N 7520 neu muss unter Gelblichtbedingungen verarbeitet werden, da er ebenfalls über eine hohe Lichtempfindlichkeit im Wellenlängenbereich von 300 – 380 nm verfügt.
Mit SX AR-N 7530/1 wollen wir einen neuen negativen E-Beamresist vorstellen, der auch unter Weißlichtbedingungen verwendet werden kann und über genauso gute Eigenschaften verfügt wie der inzwischen gut etablierte Resist AR-N 7520 neu. SX AR-N 7530/1 ermöglicht ebenfalls Auflösungen bis etwa 30 nm bei etwa gleicher Empfindlichkeit. Der Resist eignet sich auch für eine UV-Strukturierung im Wellenlängenbereich von 250 – 290 nm und kann daher auch für mix & match Anwendungen eingesetzt werden.
Kleinere Strukturen benötigen eine höhere Dosis. Das zeigt sich auch im Fall von SX AR-N 7530/1. Die Abhängigkeit der Dosis von der Strukturbreite ist in der folgenden Abbildung 1 dargestellt. Bei einer Strukturbreite von 5 µm wird nur eine Dosis von ca. 13 µC/cm² (30 kV) benötigt. Für 100-nm-Linien liegt die benötigte Dosis dagegen im Bereich von 35 – 40 µC/cm². Sehr ähnliche Ergebnisse wurden auch für AR-N 7520 neu erhalten.

Abb. 1: Dosisabhängige Breite der Linien
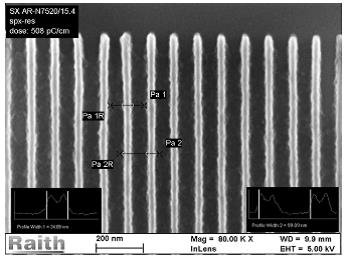
Abb. 2: Steg von 35 nm mit dem Muster SX AR-N 7530/1
E-Beam Resist Negativ
