CAR 44 für die E-Beam-Lithographie
Schichtdicken über 5 µm werden für die Elektronenstrahllithographie nur selten benötigt. Vereinzelt wurde versucht, PMMA-Schichten bis 20 µm Schichtdicke mittels Elektronen zu strukturieren. Der PMMA-E-Beamresist AR-P 6510 ist dafür geeignet, jedoch benötigt man für die Entwicklung spezielle Entwickler (AR 600-51) und Stopper (AR 600-61). Bei einer Entwicklung mit den üblichen MIBK/Isopropanol-Entwicklern reissen die Schicht beim Entwickeln.
Uns ist es nun gelungen, eine bemerkenswerte Lösung für die E-Beamstrukturierung hoher Schichten zu finden. Der Negativresist CAR 44 (AR-N 4400-10) wurde 9,5 µm hoch beschichtet, getrocknet und bestrahlt.
Mit einer Dosis von etwa 40 µC/cm² (100 kV) wurden 2 µm breite Stege geschrieben, vernetzt bei 105 °C und mit dem Entwickler AR 300-26 entwickelt.
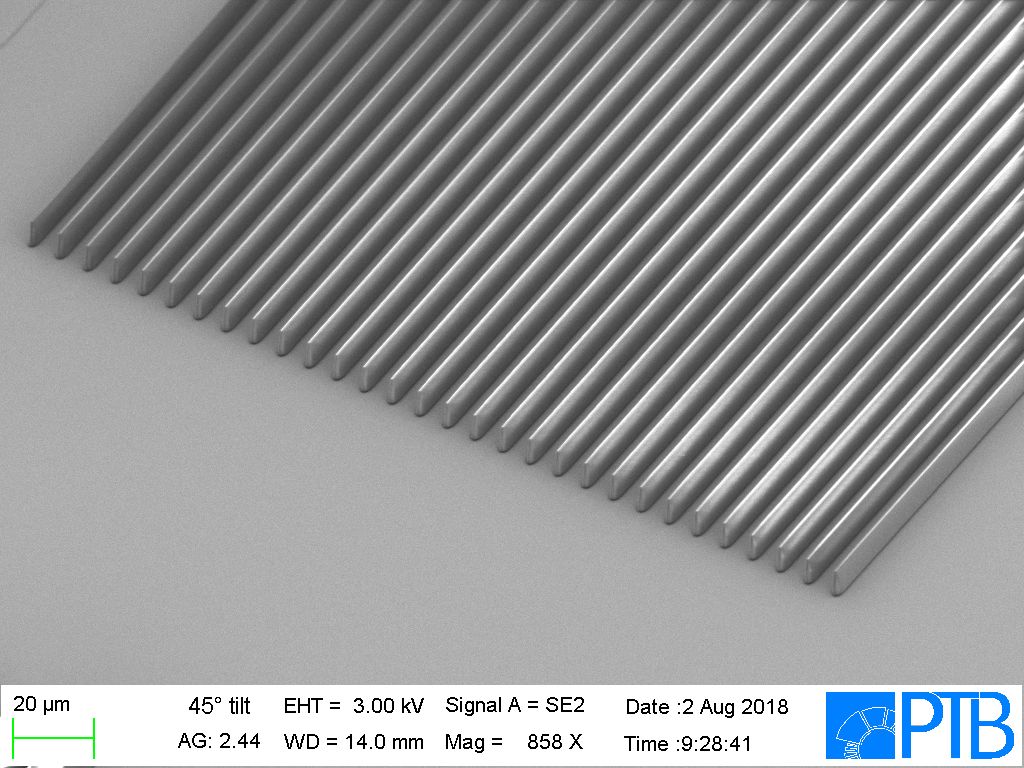
Mittels E-Beamlithographie erzeugte 2 µm Stege, 9,5 µm hoch
Noch höhere Schichtdicken sind ebenfalls strukturierbar. Damit bietet sich CAR 44 auch als Elektronenstrahlresists an.
