CSAR 62 Einlagen-lift-off System
Mit unserer Neuentwicklung E-beam Resist AR-P 6200 (CSAR 62) lassen sich sehr feine Strukturen, wie z.B. 10nm breite Gräben, mit sehr hohem Kontrast >14 generieren bei vergleichsweise hoher Empfindlichkeit.
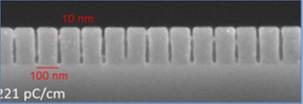
Abbildung 1: Max. Auflösung des CSAR 62 von 10 nm (180 nm).
So wurde zum Schreiben 10nm breiter Gräben bei einer Schichtdicke von 180nm eine Belichtungsdosis (dose to clear) von lediglich 220 pC/cm benötigt (30 keV, Entwickler AR 600-546). Durch Einsatz einer 1,5-2 fach höheren Strahlungsdosis lassen sich aufgrund des Proximityeffekts schmale Gräben, im gleichen Größenbereich, mit einem definierten Unterschnitt erzeugen.

Abbildung 2: Unterschnittene Strukturen durch erhöhte Dosis.
Ergänzung 03/2018
Ergebnisse Prof. Smith, Massachusetts Institute of Technology, Cambridge USA
CSAR 62 (AR-P 6200.09) wurde bei 4000rpm beschichtet und mit einem Raith SEBL System mit 30kV belichtet. Es wurden Stege mit variabler Distanz im Bereich von 400 nm bis zu 1000 nm erzeugt. mit Zur Vermeidung von elektrostatischer Aufladung wurde Electra 92 als Top-Schicht verwendet. Schichtdicke 190nm, Entwickler AR 600-546, Entwicklungszeit 60s, Stopper IPA. Die entwickelten Resist-Architekturen wurden im REM evaluiert.
