Die lichtempfindliche Komponente in unseren Positiv-Photoresists gehört zur Gruppe der Diazo-Naphtoquinone (DNQ), deutsch Naphthochinondiazide (NCD). Die Zugabe von DNQ-Derivaten zu Kresolharzen (Novolake) bewirkt eine Wechselwirkung zwischen den OH-Gruppen der Novolake und dem DNQ. Die OH-Gruppen des Novolakes, die alkalilöslich sind, werden durch die NCD blockiert (inhibierender Effekt), der alkalische Entwickler kann nicht mehr angreifen. Die Alkalilöslichkeit sinkt um etwa 2 Größenordnungen. Nach der Belichtung durch eine Belichtungsmaske im UV-Bereich (308 – 450 nm) reagiert die lichtempfindliche Komponente zu Indencarbonsäure-Derivaten und wird dadurch bei Positivlacken etwa um den Faktor 1.000 alkalilöslicher (siehe Abbildung). Zudem werden die alkalilöslichen OH-Gruppen der Novolake wieder freigesetzt.
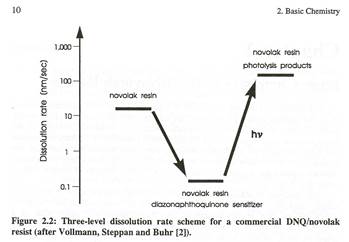
Abbildung 1: Drei-Level-Schema für die Löslichkeitsrate eines kommerziellen DNQ/Novolak-Resists. [Dammel 1]
Nach der Entwicklung bleiben nur die durch die Maske geschützten Bereiche stehen, während die belichteten abgelöst werden.
Eine Belichtung mit kurzwelligem Licht im Wellenlängenbereich < 450nm bewirkt eine Zersetzung der Naphtochinondiazidester unter Stickstoffabspaltung (siehe Abb. 2).

Abbildung 2: Beispiel für die Umwandlung von Naphtochinondiazidester zur Indencarbonsäure (Süss-Reaktion).
Die dabei gebildete reaktive Carben-Zwischenstufe bildet mit Wasser (Süss-Reaktion) Indencarbonsäure-Derivaten, die sich aufgrund ihrer um 3 – 4 Größenordnungen erhöhten Acidität viel schneller in wässrig-alkalischen Entwicklern lösen.
Die Entwicklungsgeschwindigkeiten der belichteten und der unbelichteten Flächen hängt von dem Gehalt der LEK ab. Mit zunehmendem Gehalt wird die Lösegeschwindigkeit der unbelichteten Schicht immer langsamer, bei einer ausreichend belichteten Fläche nimmt die Geschwindigkeit aufgrund der erhöhten Konzentration an alkalilöslichen Indencarbonsäuren zu (siehe Abbildung 4). Zur Erzielung der höchsten Empfindlichkeit ist es ausreichend, wenn ca. 30 – 40 % der LEK in der Schicht belichtet werden. Die vollständige Belichtung kostet nur zusätzliche Lichtenergie, die Lösegeschwindigkeit erhöht sich aber nur unwesentlich, da der inhibierende Effekt bei einer 40 %igen Belichtung schon weitgehend aufgehoben ist.

Abbildung 3: Löslichkeitsrate eines unbelichteten und voll belichteten DNQ/Novolak-Gemisches als Funktion des DNQ-Anteils. [Dammel 2, Quelle: “Diazonaphthoquinone-based Resists” von Ralph Dammel]

Abbildung 4: Veränderung des Absorptionsverhaltens von Positiv-Photoresisten durch Belichtung mit kurzwelligem Licht.
Durch Belichtung nimmt die Intensität der charakteristischen Absorptionsbanden der Naphtochinondiazidester bei 345nm und 395nm stark ab außerdem zeigt sich eine ausgeprägte Blauverschiebung.
